 2022.08.25?
2022.08.25?晶圓可靠性測試在車規級SiC芯片的必要性:
根據浴盆曲線理論任何電子元件在生命周期的初期會有一個高故障率,隨著時間的推移故障率會明顯下降到穩定期。

車規SiC功率模塊和普通的TO封裝器件不同,普通的TO封裝器件內部只有一顆DIE,如果失效只需替換單顆器件就可以了,但是車規SiC功率模塊內部保護十幾顆到幾十顆DIE,如果有一顆DIE失效整個模塊性能就會受到影響。所以如果可以把不良DIE提前從晶圓上就篩選出來可以大大提升封裝成模塊的良率和模塊的生命周期。
聯訊提供了晶圓老化整套的解決方案包含CP-上料機-晶圓老化-下料機-KGD解決了封裝成模塊之前的全套測試方案。
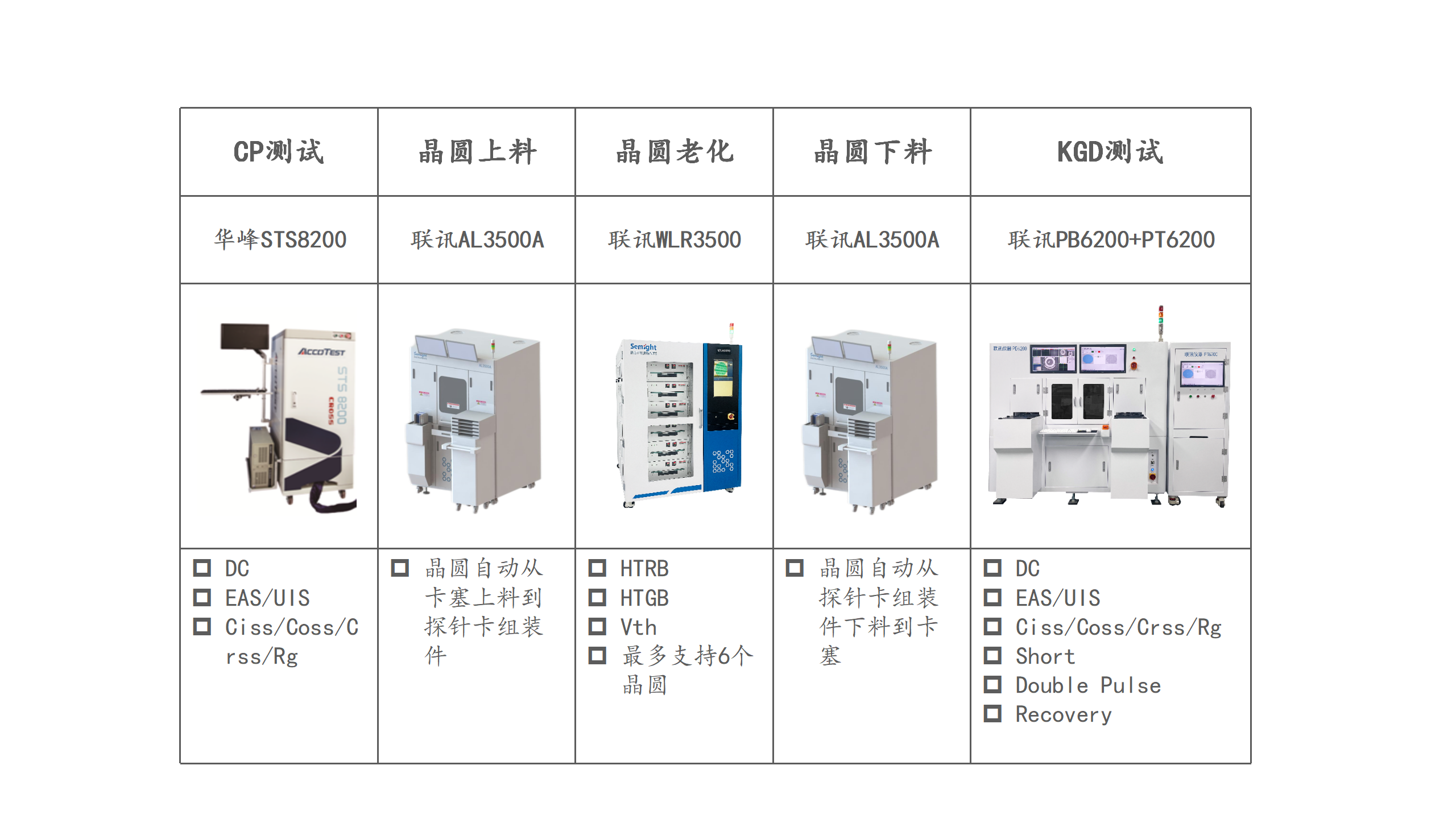
晶圓老化機: WLR3500參數
適用于GaN, SiC車規晶圓老化
最多支持12個GB或6個GB&RB晶圓同時老化
每個抽屜獨立控溫獨立加電
HTGB電壓+/-50V,HTRB電壓3000V
整套系統最多支持8544(712*12)個通道(HTGB)
老化中測試漏電流分辨率0.1nA
完善的硬件電路保護每一路電路
高可靠性的>4Bar大氣壓的氣體保護
支持Igss, Idss, Vth測試
溫度范圍RT-200C
軟件支持test plan調表式配置
軟件支持自動判定pass/fail
軟件支持按客戶定義規則分bin,并生成相應的map圖
郵箱
服務熱線
關注
姓名
郵箱地址
郵箱驗證碼
電話
密碼
確認密碼
郵箱地址
郵箱驗證碼
新密碼
確認密碼